键合能测试仪/晶圆键合测试仪

- 名称: 键合能测试仪/晶圆键合测试系统
- 型号: RUIDING-DTS
- 品牌: 瑞鼎智造
产品详情
直接键合(Direct Bonding Methods):无中间层或粘合剂,通过表面分子间作用力直接将两个基板结合,硅-硅直接键合或硅-氧化硅键合。【通常在0.1-2.5 mJ/m²之间】
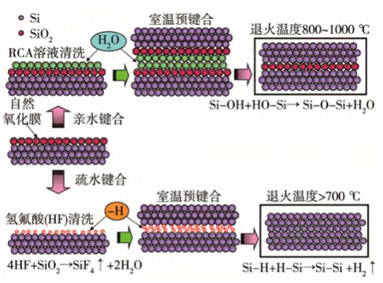
混合键合(Intermediate-Layer Bonding Methods):一种多功能晶圆键合技术,它使用中间材料连接基板,从而能够集成不同的材料(例如硅、玻璃、金属、聚合物)。
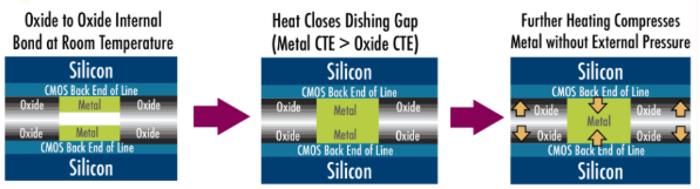
混合键合的键合能由两部分组成:介质层键合能和金属层键合能。【键合能是介质层和金属层键合能的综合结果,通常在 2-4 J/m² 范围内】
键合能测试原理
键合能(Bonding Energy)/结合能:表示将两个表面分离所需的能量,通常以J/m²表示。它在数值上等同于断裂能,即临界应变能释放率。
临界应变能释放率Gc 是材料界面断裂时释放的能量,单位为 J/m²
断裂有两种:粘附性断裂(界面)和内聚性断裂(材料本身);对于粘附性和内聚性断裂过程,断裂能可以用临界应变能释放率Gc来量化。
临界应变能释放率Gc反映了界面结合的强度:
高界面能:表明界面结合牢固,断裂时需要更多能量。
低界面能:表明界面结合较弱,断裂时释放的能量较少。
在晶圆键合中,临界界面能是评估界面质量的核心指标。
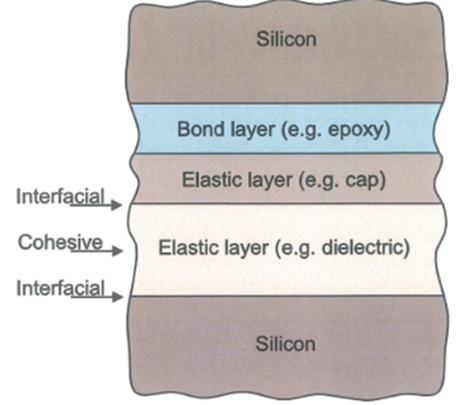
由硅、氧化物、金属等材料层叠构成的半导体器件,材料之间的键合强度对器件的电气性能、热导率和机械强度有显著影响。瑞鼎智造最新推出的晶圆键合力测试系统是一种先进的微机械测试系统,能够满足键合界面结合强度评估的需求。
功能:
拉伸(双悬臂梁配置(DCB))测试:DCB(双悬臂梁,Double Cantilever Beam)测试是一种用于材料测量临界断裂能和亚临界裂纹扩展的实验方法。其原理基于线弹性断裂力学(LEFM),通过测量裂纹扩展所需的能量来评估材料的抗裂性能。DCB技术对双悬臂梁样品的一端施加张力进行分层,测量裂纹长度和临界载荷,计算临界应变能释放率Gc。
DCB技术的关键是创建一个“弱区域”,从那里可以启动预裂纹。


DTS-DCB 键合能测试优势:最小化残余应力释放
夹心结构的设计:在 DCB 测试中,薄膜被夹在两个较厚的弹性基底之间。薄膜的厚度 ℎ远小于基底厚度 𝐻,因此薄膜的应力释放对基底的整体变形影响很小。基底的高刚度(例如硅的杨氏模量 𝐸≈170 GPa )限制了薄膜应力的释放,薄膜中的残余应力主要通过基底的弹性变形来平衡,而不是通过显著的应力释放。
|
DCB测试临界断裂能应用
利用DCB测试W2W界面能应用:
1.工艺
2.位置
3.薄膜种类
4.键合种类

在W2W样本的DCB测试中获得的代表性载荷-位移曲线
 不同种类薄膜的界面能
不同种类薄膜的界面能
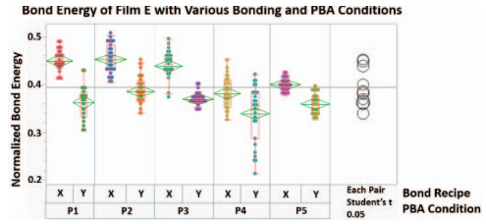 薄膜E在不同键合条件和PBA条件下的键能
薄膜E在不同键合条件和PBA条件下的键能

在晶圆中心和边缘测量的具有不同键合条件的薄膜D的键合能
 混合键合与融合键合之间的键能比较
混合键合与融合键合之间的键能比较
